PRODUCTS製品情報
半導体製造装置
貼合・剥離装置
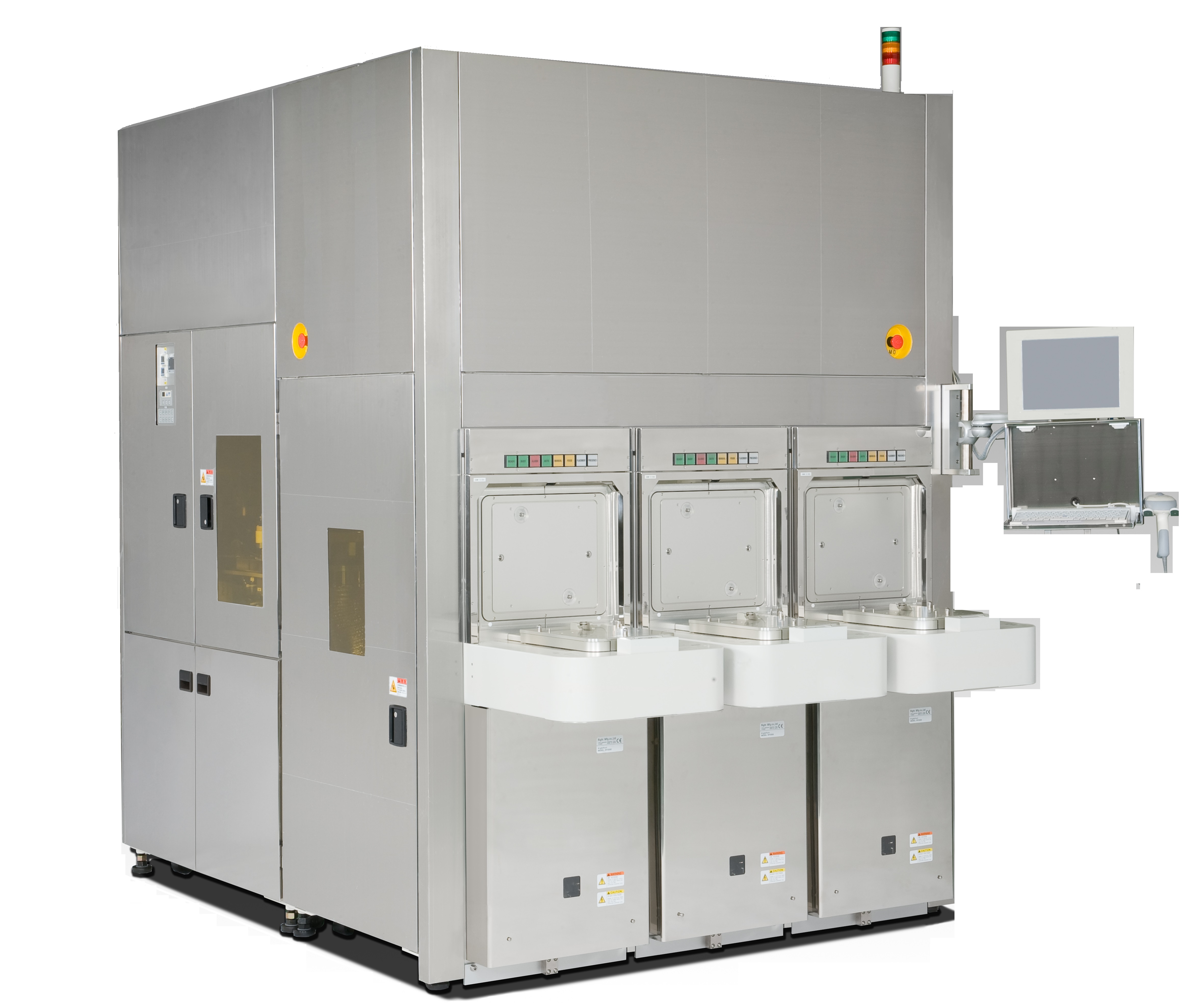
TWSシリーズ 塗布貼合装置
高度な3次元実装、デバイス薄化の脆弱性対策等を目的としたウェーハの極薄化を支援し、半導体パッケージングの更なる小型化、省エネを進めるために開発/設計されました。
弊社の塗付技術を駆使した均一な膜圧塗布を行い、支持体と貼合した後に紫外線で硬化させます。
製品特徴
プラットホーム
###タツモの長年のコーター開発の技術を生かし、UV硬化型材料に特化した最適な装置を開発。
###塗布から、貼合まで自動で行います。
プロセスユニット
###25WPH以上のスループットを達成
###3um以下のTTV(ウェハの平坦度適用領域での厚さの最大値と最小値の差)を達成
###常温貼り合わせ(UV硬化樹脂を採用)により支持基板との貼り合わせの際に熱による衝撃はほとんどありません。
###支持基板を繰り返し使用する事が可能でコスト低減に貢献します。
###ガラスのリサイクル装置もご用意しております。
###ドライプロセス…貼り合わせ、剥離は完全ドライプロセスにより行われます。
操作性
###GUI画面による優れた操作性を実現。複雑なレシピ編集も簡単にできます。
製品規格
- 処理ワーク
- ■2000シリーズ φ150~200mmウェーハ(±1.0) ■3000シリーズ φ200~300mmウェーハ(±1.0)
- 支持体基板
- GLASS。処理ワークの0.5~ 1.0mmの大口径のものを推奨。
- スピンカップ
- 搭載 (有機溶剤の使用なし)
- 貼り合わせ機構
- 搭載
- カセット形式
- ■2000シリーズ 通常OPENまたは、倍ピッチカセット ■3000シリーズ FOUP/FOSB
- その他
- 安全仕様準拠
プロセス1事業 営業課
(086)239-5530
(086)239-5511
