PRODUCTS
Semiconductor Manufacturing Equipment
Bonder/Debonder

TWH Series Mechanical Debonder Cleaner
The equipment that debond the carrier from a device wafer that is bonded with a thermosetting / UV curable adhesive/releasing layer.
After mechanical debonding, it automatically cleans the residue on the wafer.
Tape frame handling realizes the device wafer can be thinned to the limit of possible numerical values in theory.
Features
Platform
###Multi Layout system; Stand alone, semi-automatic and fully automatic equipments are available.
Process Unit
###Mechanical Debonding unit
###Wafer Cleaner
###Various safety specifications; explosion-proof, fire difence law."
Operability
###Excellent operability with a GUI(Graphical User Interface)screen achieves easily edit complicated recipes.
Specification
- Automatic Mechanical debonder cleaner
- TWH-SR-CC series
- Substrate sizes
- φ200mm-300mm wafer on tape frame
- Wafer Loader/Unloader
- Tape frame cassette / Loadport
- Carrier wafer Unloader
- Open cassette
- EFEM
- Transfer Robot and Aligner
- Mechanical Debonding Unit
- 1 unit only
- Cleaning Unit
- Max 2 units
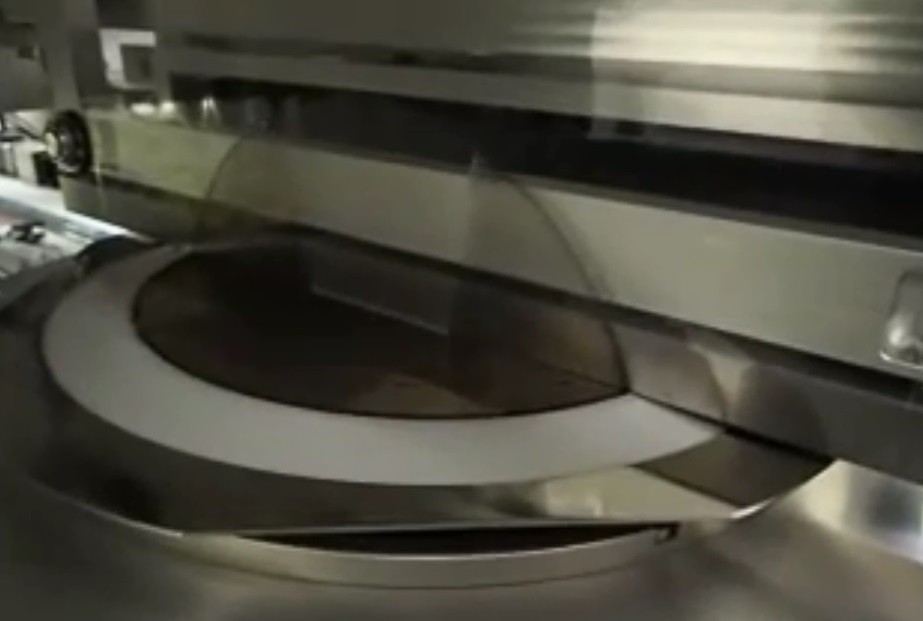
TWH Series PEEL Unit
Peeling off the residues remaining on the device wafer surface after debonding carrier. This peeling is performed by peeling tape.
It is recommended in the dry process and cost reduction.
Features
Platform
###Multi Layout system; Stand alone, semi-automatic and fully automatic equipments are available.
Process Unit
###Peel pressure monitoring function
###Tape Frame free function(Option)
Operability
###Excellent operability with a GUI(Graphical User Interface)screen achieves easily edit complicated recipes.
Specification
- Peel Unit
- TWH-PL series
- Substrate sizes
- φ200mm-300mm wafer
- Peeling Pressure
- 0 ~ 300 N
- Peeling Speed
- 0 ~ 20 mm/sec
- Peel tape core diameter
- φ76.8 mm
- Other
- comforms to safety standards
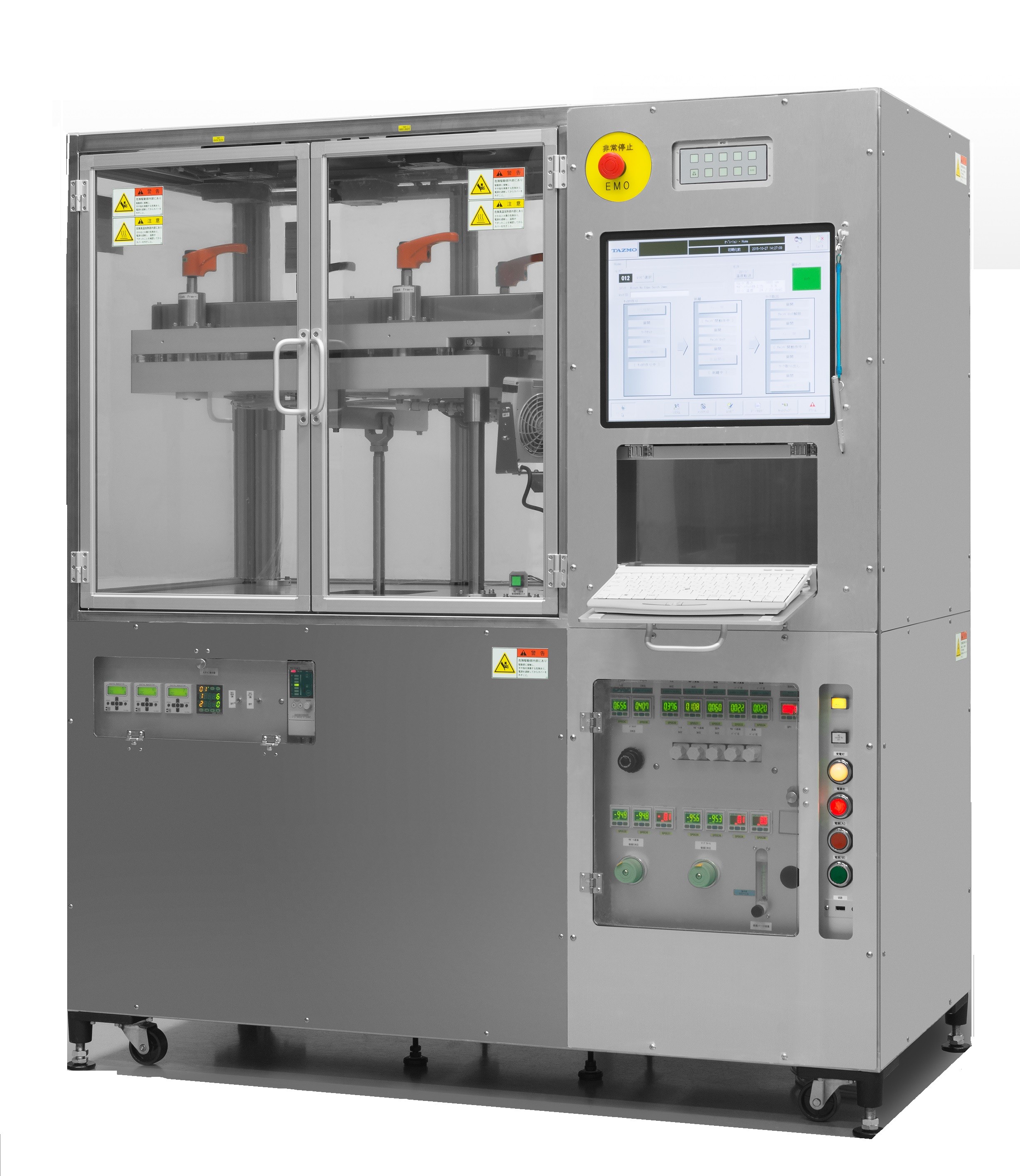
TWH Series Mechanical Debonder Cleaner
TAZMO has developed an overwhelming mechanical debonder over many years.
It has a strong power and soft structure for the device wafer and carrier.
(Patent Pending)
Features
Platform
###Available for thermosetting / UV curable adhesive
(room temparature) Mechanical debonding equipment
Process Unit
###TAZMO special desigh debonding Unit,(Patent Pending) Ultra Smoothness
###Processing wafer on Tape Frame.
Operability
###Excellent operability with a GUI(Graphical User Interface)screen achieves easily edit complicated recipes.
Specification
- Mechanical Debonder
- TWH-SR series
- Substrate sizes
- φ150mm-300mm wafer
- Carrier Wafer
- Si, glass, etc
- Wafer handling
- Tape frame handling
- Wafer Chuck
- Porous chuck
- Debonding Method
- TAZMO Designed Blade method
- Other
- Room temparature process
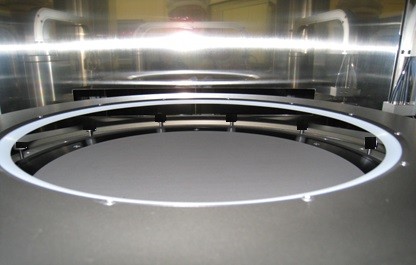
TWH Series Cleaner
Each wafer on tape frame can be cleaned with especial designed unit.
The tape frame has no solvent contact, but only devise wafer due to the special guard during cleaning process.
Features
Platform
###Multi Layout system; Stand alone, semi-automatic and fully automatic equipments are available.
Process Unit
###high-step device application
###Selectable nozzle system
###Available with 2 fluid sprays
###Available with an ultrasonic cleaning
###Waste liquid tank filtration method
Operability
###Excellent operability with a GUI(Graphical User Interface)screen achieves easily edit complicated recipes.
Specification
- Cleaner
- TWH-CC series
- Substrate sizes
- φ150mm-300mm wafer on tape frame
- Rotation Speed
- 0 ~ 1500[rpm]
- Nozzle Qty
- Max 2 nozzles for each chamber
- Other
- comforms to safety standards
TWH Series Bonder
TAZMO new Bonder handling thermosetting type/thermoplastic type materials is available.
This new Bonder based on tool conept of cost-effectiveness as well as high-performance will satisfy customer's requirements.
Features
Platform
###Multi Layout system; Stand alone, semi-automatic and fully automatic equipments are available.
Process Unit
###Temperature up to 250℃
###Not only Glass bus also Si wafer can be used as support carrier
Operability
###Excellent operability with a GUI(Graphical User Interface)screen achieves easily edit complicated recipes.
Specification
- Bonder
- WH-BD series
- Substrate sizes
- φ200 or 300 mm
- Alighment accuracy
- X-Y: 30μm
- Bonding pressure
- φ300: 20kN φ200:10kN
- Wafer Chuck
- Electrostatic chuck
- Temperature
- Up to 250℃
- Vacuum pressure
- < 10Pa
- Bonding accuracy
- TTV < 3μm *uing bare wafer with 50μm film thickness
- other
- comforms to safety standards
Sales Div. Process1 Business Unit
(086)239-5530
(086)239-5511

